
Êú¨ÊñáÂØπÊØîÁÝîÁ©∂‰∫ÜÂïÜÂìÅÂåñÈì∂ʵ܉ΩìÁ≥ªÂíåÊñ∞Èì∂ʵ܉ΩìÁ≥ªÁöÑÊ∂¶ÊπøÊÄßÂØπËäØÁâáÈîÆÂêàÊÄßËÉΩÁöÑÂΩ±Âìç„ÄŸbr/>
Èì∂ʵÜÔºöÊñ∞ÂûãÈì∂ʵ܉ΩìÁ≥ªÔºàËÆ∞‰∏∫ BÔºâÔºåÂÖ∂‰∏éÈì∂ʵÜA‰ΩìÁ≥ªÁöÑÂå∫Âà´Âú®‰∫éÁ≤òÂêà‰øÉËøõÂâÇÁöщ∏çÂêå„ÄŸ/span>
Âü∫Â∫ïÔºöÁéØÊ∞ßÁéªÁ∫§Âü∫Êùê„ÄŸ/span>
ÈááÁî®Âæ∑ÂõΩ KR√úSS ÂÖ¨Âè∏Áö DSA100 ʵãÈáèÈì∂ʵ܉∏éÂü∫ÊùêÁöÑÊé•Ë߶Ëßí„ÄŸ/span>

DSA100接触角测试仪
Èì∂ʵÜBÂú®Âü∫Êùê‰∏äÁöÑÊé•Ë߶Ëßí‰Ωé‰∫éÈì∂ʵÜAÔºåË°®ÊòéÈì∂ʵÜBÁöÑʵ∏Ê∂¶ÊÄßËâØ•ΩÔºåÊúâÂ੉∫éÂú®Âü∫ÊùøÂíåËäØÁâá‰∏≠Èó¥‰∫ßÁîüËøûÁª≠ÁöÑÈì∂ʵܱDŽÄŸ/span>
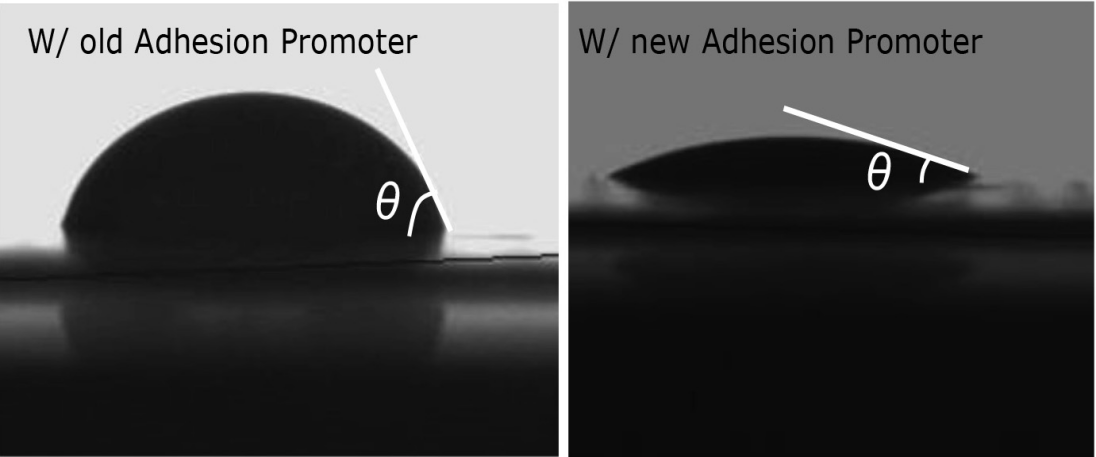
ËÄåÂâñÈù¢ÂΩ¢Ë≤åÂàÜÊûê‰πüËØÅÂÆûÈì∂浆 BÂú®ËäØÁâáË°®Èù¢ÂΩ¢Êàê‰∫ÜËøûÁª≠ÁöÑÈì∂ʵÜÈîÆÂêà±DŽÄÇÂØπÈì∂ʵÜAÁöÑËäØÁâáÈîÆÂêà±ÇÂâñÈù¢ËøõË°åËßÇÂØüÔºåÂèëÁé∞Èì∂ʵÜAÁöÑÈîÆÂêà±ÇÂ≠òÂú®Á©∫Ê¥ûÔºåËØÅÊòéÈì∂ʵÜÂú®ÁÇπËÉ∂ËøáÁ®ã‰∏≠Ê≤°ÊúâÂÆåÂ֮ʵ∏Ê∂¶Âü∫ÊùêÁöÑË°®Èù¢Ôºå‰ΩøÁ©∫Ê∞îÂ∞ÅÈó≠Âú®ÈîÆÂêà±lj∏≠„ÄÇËÄåÁ©∫Ê∞îÂú®Èì∂ʵÜÂõ∫ÂåñÁöÑËøáÁ®ã‰∏≠ÂèóÁÉ≠ËÜ®ËÉÄÔºå‰∏牪ÖÂáèÂ∞è‰∫ÜÁïåÈù¢Â§ÑÁöÑÈì∂ʵÜÁªìÂêàÈù¢ÁßØÔºåÂá躱‰∫ÜÈîÆÂêàº∫Â∫¶ÔºåËÄå‰∏î‰πüÂغË᥉∫ÜËøáÈ´òÁöÑÈîÆÂêà±ÇÂéöÂ∫¶„ÄŸ/span>

Âõ?ÔºåÈì∂ʵ B ÈîÆÂêà±ÇÂâñÈù¢ÁöÑ SEM ÁÖßÁâá
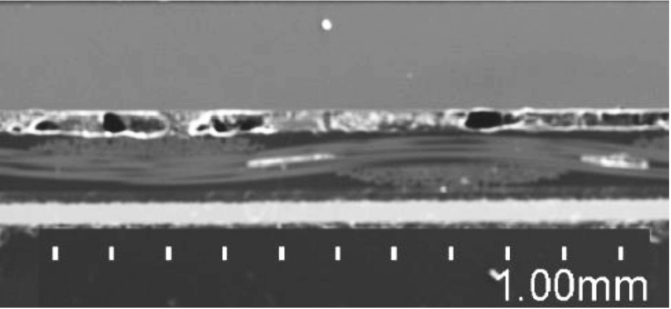
Âõ?ÔºåÈì∂ʵ A ÈîÆÂêà±ÇÂâñÈù¢ÁöÑ SEM ÁÖßÁâá
ÂèØÁúãÂá∫ÂáèÂ∞ëÈì∂ʵܱÇÁöÑÁ©∫Ê¥ûÊòØÊèêÈ´òËäØÁâáÈîÆÂêàº∫Â∫¶Áöщ∏ÄÁßçÊúâÊïàÊñπÊ≥ï„ÄÇÂêàÈÄÇÁöÑÁ≤òÂêà‰øÉËøõÂâÇÂè؉ª•Â∏ÆÂä©Â¢ûÂäÝÈì∂ʵÜÂú®Âü∫ÊùêË°®Èù¢ÁöÑʵ∏Ê∂¶Âπ∂ÂáèÂ∞ëÁïåÈù¢Èì∂ʵܱÇÈáåÁöÑÁ©∫Ê¥û„ÄŸ/span>
参考文献:
Êú¨ÊñáÊúâÂàÝÂáèÔºåËضÁªÜ‰ø°ÊÅØËØ∑ÂèÇËÄÉÂéüÊñá„ÄŸ/span>
ÂݵÁæéÂÜõÔºåÊ¢ÅÂõΩÊ≠?È´òËäØÁâáÈîÆÂêàË¥®Èáè‰∏éÈ´òÁîü‰∫ßÁéáÁöÑÊñ∞ÂûãÈì∂ʵ܉ΩìÁ≥ªÁöÑÁÝîÁ©∂[J].‰∏≠ÂõΩÈõÜÊàêÁîµË∑Ø,2021,1-2(260-261): 63-69.
 1450
1450
 4
4
-
1GBT 15065-2009 电线电缆用黑色聚乙烯塑料
-
2GB_T2951.41-2008电缆和光缆绝缘和护套材料通用试验方法
-
3GBT 13021-2023 ËÅöÁÉØÁÉÉÁÆ°ÊùêÂíåÁÆ°‰ª∂ ÁÇ≠ȪëÂê´ÈáèÁöÑʵãÂÆ ÁÖÖÁÉßÂíåÁÉ≠ËߣÊ≥ï
-
4PEG熔融相变温度测试
-
5ËÅöÁ¢≥ÈÖ∏ÈÖØ(PC) DSCʵãËØïÁéªÁíÉÂåñËΩ¨ÂèòÊ∏©Â∫?/a>
- DSC测试PET熔点和玻璃化转变温度
-
7Èáë±ûÊã≺∏ËØïÈ™åÊÝáÂáÜËØïÊÝ∑Á±ªÂûãÂèäÂ∞∫ÂØ∑¸/a>
- ÂíåÊôü‰ª™Âô®ÊãâÂäõËØïÈ™åÊú∫Âú®ÈÉ®ÂàÜÈ´òÊÝ°ÁÝîÁ©∂ÊâÄÂ∫îÁî®ÂÆû‰æã

- EVAÂûãÁÉ≠ÁÜîËÉ∂‰π¶ÂàäË£ÖËƢº∫Â∫¶Ê£Äʵã‰∏éË¥®ÈáèÊéßÂà∂ÁÝîÁ©∂
- Ëá™Âä®ÁÉ≠ÂéãÊú∫ÁöÑÂèë±ïË∂ãÂäøÊòØÊÄéÊÝ∑ÁöÑÔºü
- Áî®Êà∑ËÆ∫ÊñáÈõ ‚ñèÂåñÂ≠¶Âê∏Èô ‚ñèÈì±-ÈìºÂÖ±Ê≤âÁß؉πôÈÜá§ÑÁêÜÂêéSiO2ËΩΩ‰ΩìÂǨÂåñÂâÇÂ∫îÁî®Âú®ÁîòÊ≤πÊ∞¢ËߣÂèçÂ∫î
- ‰∏∫‰ªÄ‰πàËøëÊúüÂçï£ÅÁ¢≥Á∫≥Á±≥ËßíÔºàCNHÔºâÁöÑÁÝîÁ©∂Ëøõ±ïÂĺÂæóÂÖ≥Ê≥®Ôºû¸/a>
- ‰∏∫‰ªÄ‰πà‰ªãÂ≠îSiO2Âú®ËçØÁâ©ÈÄíÈÄÅÈ¢ÜÂüüÁöÑÂ∫îÁî®Ë∂äÊù•Ë∂ä§öÔºû¸/a>
- FRITSCHÈ£ûÈ©∞ÁêÉÁ£®‚Äî‚Äî‰∏çÈîàÈí¢‰ªãÂغÁöÑÊ∞¥‰∏≠ÁêÉÁ£®Êù°‰ª∂‰∏ãÂÆöÈáèH2ÁîüÊàêÂÆûÈ™åÁÝîÁ©∂
- ‰∏∫‰ªÄ‰πàMoS2Âú®ÂǨÂåñÈ¢ÜÂüüÁöÑÁÝîÁ©∂Ëøõ±ïÂĺÂæóÂÖ≥Ê≥®?
- È£ûÁ∫≥Âè∞ºèÊâ´ÊèèÁîµÈïúÂä©ÂäõÁ∫≥Á±≥Á∫§Áª¥Âú®ÂøÉË°ÄÁÆ°ÁªÑÁªáÂÜçÁîü‰∏≠ÁöÑÁÝîÁ©µ¸/a>
- DSRËÆ∫ÊñáËߣËتԺöAdvanced Science News Êä•ÈÅì‰∏≠ÁßëÈô¢ÈïøÊò•Â∫îÂåñÊâÄÊñ∞ÂûãÈùûÈìÇÂǨÂåñÊùêÊñôÁÝîÁ©∂ÊàêÊûú
- High-throughput preparation, scale up and solidification of andrographolide nanosuspension using hummer acoustic resonance technologyÔºàÁ∫≥Á±≥Ê∑∑ÊǨÂâÇÂà∂§áÁöÑÂâçÁûªÊÄßÊäÄÊú - ËúÇÈ∏ü£∞ÂÖ±ÊåØÔºâ
- Êâ´ÊèèÁîµÈïú‰ºòÁßÄËÆ∫Êñá˵èÊûêÔΩúÈ£ûÁ∫≥Âè∞ºèÊâ´ÊèèÁîµÈïúÁîµÊûÅÊùêÊñô‰∏äÁöÑÂ∫îÁî?/a>
- Êâ´ÊèèÁîµÈïúËÆ∫Êñá˵èÊûê-Âπ≤Êó±ÂΩ±ÂìçÊù®ÊÝëÂè∂ÁâáÂèäʨ°ÁîüÊú®Ë¥®ÈÉ®ÂèëËÇ≤ÁöÑÂàÜÂ≠êÊú∫Â൸/a>
- 压实度与密实度的区别
- 振实密度和压实密度的关系
- 勃姆石专用气流粉碎机分级机打散机
- 国产新品泡沫起升仪可替代德国format

Copyright¬©2002-2024 Cnpowder.com.cn Corporation,All Rights Reserved ÈöêÁßʼnøùÊä§ ‰∏≠ÂõΩÁ≤â‰ΩìÁΩ ÁâàÊùÉÊâÄÊú ‰∫¨ICPËØ?50428Âè∂¸/p>

