 钻石会员
钻石会员
 已认�?/p>
已认�?/p>
浆料粒径寸�/span>CMP工艺缺陷水平的影哌�/span>
通过使用两种粒度测量仪器,对最常用的化学机械抛光(CMP)氧化物浆料'�/span>CabotSC-112)的浆料粒度进行了分析。其中一种仪器是PSS粒度仪公司的Nicomp 370,用于监测平均粒径为100nm左右的浆料颗粒的主要群体。另一种仪器,Accusizer 770被发现是有效的监测粒径大亍�/span>1μm。粒径分布测试是从供应商源容器和CMP机器上的使用点进行的,这些结果与BPSG CMP过程的缺陷级别相关。在研究过程中发现,浆料磨料颗粒的主要种群在样品间变化不大。然而,一小部分(;�/span>0.01%)的大浆料颗粒在晶圆上颗粒数量的增加有关。经过仔细检查,发现这些颗粒是嵌入的浆料颗粒和微小的划痕、�/span>
介绍
化学机械抛光的氧化物涉及使用磨料提供必要的整体和局部平整。虽然研究主要集中在CMP机器参数、抛光耗材咋�/span>CMP清洗后等方面,但对浆料额分析主要是由浆料的制造商来完成的。本研究的目的是提供一些洞见关于浆料颗粒分布对缺陷的影响,浆液过滤的重要性,以及名�/span>CMP清洗过程对这些缺陷的脆弱性、�/span>
实验
Cabot SC-112浆液仍�/span>3个不同的来源取样。第一个来源是使用点上皃�/span>IPEC/Westech CMP机器。浆料系统是IPEC/Westech设计的系统。该系统由一�?/span>25加仑的储罐组成,该储罐使用再循环回路,以不断保持浆料溶液的搅动。在IPEC/Westech CMP机器的上游,放置了一个使�?/span>30微米一次性过滤筒的过滤壳,用于评估过滤效率、�/span>CMP机器上的蠕动泵将把浆液从循环回路中取出。剩余的浆料将会返回到浆料槽中(国�/span>1)、�/span>
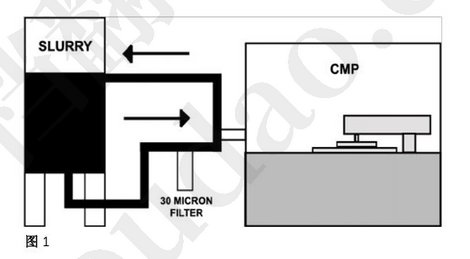
第二个来源是卡伯特公司新开皃�/span>5加仑集装箱。第三个来源是一�?/span>5加仑的容器底部,该容器已打开许多天,容器侧面的浆料已经干了。三个测试组田�/span>2个空發�/span>BOSG晶片咋�/span>1�?/span>BPSG形貌测试晶片组成� 所有晶圆片在测试前都要预先检查颗粒。根据样本来源确定三个实验组。在这种情况下,它们被标记为已过滤,新的和被污染的。晶圆片也在同一个抛光垫上按此顺序加工,这样浆料中大颗粒的数量会逐渐变差。所有晶圆都�?/span>Rodel IC-1000/suba4叠层抛光机上进行抛光,在5PSI下压力下�?/span>1分钟。晶片载体和压板速度都是24转。使�?/span>IPEC/Westech CMP机器提供的蠕动泵,已150毫升/分钟的速度抛光晶片。每组保留留栶�/span>1份,用于粒度检测。所有晶片都要用Rodel Politex Supreme抛光垫在1.5psi的温度下进行20s的二次抛光,只使用去水。晶圆和压板转速分别为50咋�/span>30rpm、�/span>
�?/span>CMP工艺之后,所有晶片都�?/span>ONTrak DSS-200洗涤器上仅使用去离子水进行清洗。随后是30秒的100:1HF浸泡,以清除任何重金属污染、�/span>
结果与讨讹�/span>
使用Tencou Surfscan 4500粒子检测器检测空發�/span>BPSG晶片。测试了大于0.24μm的光点缺陷。随后,尅�/span>500埃的钛沉积在晶圆表面以增强颗粒缺陷,并在Tencor上重新检查晶圆。在颗粒粒度系统PSS nicomp 370咋�/span>Accusizer 770颗粒粒度仪上测试了各组的固相浆料样品、�/span>Nicomp 370用于测量亚微米粒子,耋�/span>Accusizer 770用于大于1μm的粒子、�/span>Nicomp 370的结果表面,不同样品间的浆料磨料颗粒的主要数量变化不大、�/span>


在大亍�/span>1微米的颗粒大小区域,田�/span>Accusizer 770给出了发生的情况的较好指示。图3显示亅�/span>3个样本的叠加。在就得或受到污染的浆料样品中发现的颗粒数量最多,其次是新的浆料样本。正如预期的那样,在过滤浆料样品中发现的大颗粒的数量最少、�/span>

然后寸�/span>Toncor Surfscan4500的颗粒数据和Accusizer770的浆料颗粒数据进行平均和比较。从国�/span>4可以看出,抛光、双面擦洗�?/span>100:1HF浸渍后,大浆料颗粒的数量与硅片上残留的颗粒数量直接相关、�/span>

然后�?/span>KLA仪器2132型检阅台对地形进行了检查这些颗粒大部分被发现是嵌入颗粒和微划痕。照牆�/span>1

结论
本研究的结果表明,一小部分的大磨料颗粒可以直接对BPSG薄膜的高颗粒水平做出贡献。随后的抛光步骤,双面擦洗和100:1HF浸在克服这种类型的颗粒污染无效。通过对大浆体颗粒的监测可以获得更好的过程控制,并配合过滤的使用可以大大降低大浆体的颗粒的影响、�/span>



